Pourquoi vous avez besoin de nos services, vous savez que vous obtenez des professionnels hautement qualifiés qui ont l'expertise et l'expérience pour s'assurer que votre projet est fait correctement et fonctionne.

Les diodes et transistors avec canaux AlN fournissent des tensions de claquage élevées et fonctionnent à des températures incroyablement élevées.
DE NOMBREUSES activités humaines s’étendent dans des environnements extrêmes, souvent motivées par l’exploitation des ressources. Cela a conduit l’exploration dans diverses directions, y compris en profondeur sous terre, à de grandes profondeurs en mer et dans l’espace lointain. Dans tous ces environnements, la température est extrême : elle dépasse 300 °C à la surface de Vénus, lors du forage de puits profonds et dans l’espace à l’intérieur d’un moteur en fonctionnement.
En savoir plus sur tous ces environnements nécessite le déploiement de capteurs. Mais les plus évidents, c’est-à-dire ceux à base de silicium, ne sont pas à la hauteur, en raison d’une limite de température de fonctionnement relativement basse. Cela signifie que pour enrichir nos vies dans ces environnements, nous devons développer une électronique à températures extrêmes.
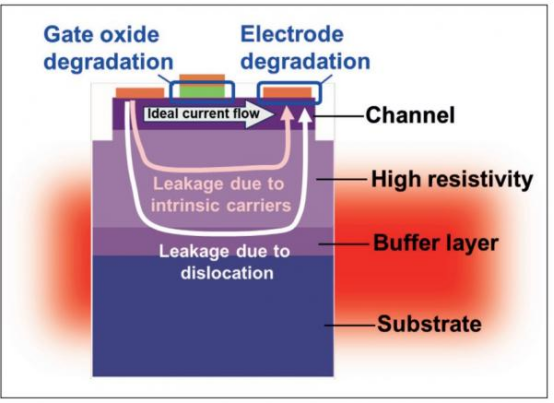
Figure 1. Le chemin du courant de fuite et les points de dégradation thermique dans un MESFET avec un oxyde de grille.
Lorsque toutes les formes de dispositifs semi-conducteurs fonctionnent à des températures extrêmes, elles sont confrontées à des problèmes liés aux matériaux, aux électrodes, aux oxydes de grille et à l'emballage (voir Figure 1). À mesure que la température augmente, de nombreuses paires électron-trou sont générées, en raison de l'excitation des électrons du maximum de la bande de valence au minimum de la bande de conduction. Ces électrons, qui augmentent la concentration en porteurs intrinsèques (voir Figure 2 (a)), sont préjudiciables, car ils augmentent le courant de fuite des appareils et les empêchent de s'éteindre. Les options pour réduire le courant de fuite incluent l'introduction de matériaux semi-conducteurs avec une énergie de bande interdite plus grande et des concentrations de porteurs intrinsèques plus faibles (voir Figure 2 (b)), ou la restriction de la diffusion du courant à partir de zones autres que le canal. Le recours à une couche de canal entourée de couches à haute résistivité présentant de faibles concentrations efficaces de donneur/accepteur et de faibles concentrations de défauts peut augmenter la température de fonctionnement du dispositif. Une autre approche consiste à déployer des appareils dotés de jonctions p-n, tels que les JFET et les BJT. Dans ces cas, il est également important de sélectionner des métaux réfractaires pour les électrodes qui ont une réactivité minimale avec les semi-conducteurs de base. En particulier, le titane, le vanadium, le tantale, le molybdène, le tungstène et le platine sont meilleurs à cet effet que l'aluminium, le magnésium, le cuivre, l'argent, l'indium et l'or.
Pourquoi utiliser l'AlN ?
Il existe de nombreux matériaux semi-conducteurs avec une énergie de bande interdite plus grande que le silicium. Ils comprennent le SiC (3,3 eV), le GaN (3,4 eV), le Ga2O3 (4,7-5,2 eV), diamant (5,5 eV) et AlN (6,1 eV). L'équipe de la NASA, dirigée par Philip Neudeck, a rapporté que les JFET SiC peuvent fonctionner à des températures supérieures à 800 °C. Bien qu’il s’agisse sans aucun doute d’un résultat impressionnant, les matériaux dotés de bandes interdites encore plus larges promettent d’atteindre des températures encore plus élevées. Cependant, bon nombre d’entre eux présentent des inconvénients importants. GaN souffre d'une concentration efficace élevée de donneurs de 1016 cm-3; il n'est pas possible de former Ga de type p2O3 couches; et le diamant commence à réagir avec l'oxygène à environ 700 °C. À l’opposé, l’AlN ne présente aucun défaut évident et offre une stabilité thermique et un dopage contrôlable. En raison de ces attributs, notre équipe de l’Université de Tsukuba a consacré toute son attention à l’AlN pour le développement de dispositifs à températures extrêmes.
Historiquement, on a supposé que l’AlN n’était efficace qu’en tant qu’isolant. Cependant, il y a environ 20 ans, Yoshitaka Taniyasu et ses collègues de NTT ont démontré que ce n'était pas le cas en développant des couches d'AlN électriquement conductrices par MOCVD.
Cette équipe a enregistré une mobilité électronique de 426 cm2 V-1 s-1 pour couches d'AlN dopées au silicium, pour une concentration en dopant de 3 x 1017 cm-3. S'appuyant sur ces travaux, ils ont été pionniers dans la croissance de l'AlN de type p et ont présenté les premières LED AlN avec une longueur d'onde de 210 nm et des diodes AlN p-n quasi verticales. Ces succès sont dus au développement récent et rapide des LED UV profonds à base d'AlGaN et d'AlN.
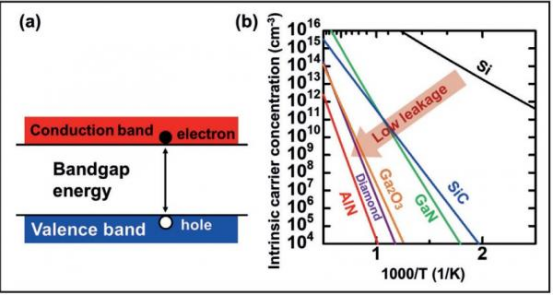
Figure 2. (a) Une illustration de la génération de paires électron-trou à haute température. (b) La concentration intrinsèque de porteurs de silicium, SiC, GaN, diamant β-Ga2O3 et AlN en fonction de la température réciproque.
Outre les dispositifs optiques, la communauté des chercheurs a étudié les diodes barrière AlN Schottky et les HEMT AlN/AlGaN, afin d'explorer les avantages potentiels d'un champ électrique critique élevé. Malheureusement, ces dispositifs souffrent d'une faible concentration de porteurs, en raison des énergies d'ionisation élevées pour les donneurs et les accepteurs : elle est de 0,3 eV pour le silicium et de 0,6 eV pour le magnésium. Pour cette raison, les concentrations de porteurs pour ces deux dopants sont environ deux ordres de grandeur inférieures à leurs concentrations, ce qui entraîne des courants très faibles dans les dispositifs. Pour surmonter ce problème, notre équipe, en collaboration avec des chercheurs du MIT et de l'Université d'Aalto, a innové en introduisant le dopage induit par polarisation dans les structures AlGaN/AlN N-polaires. Grâce aux polarisations spontanées et piézoélectriques, cette forme de dopage peut augmenter le courant et diminuer la résistivité des contacts. En utilisant le dopage induit par polarisation, nous avons démontré les premiers PolFET et HEMT à base d'AlN polaire N avec des courants de drain supérieurs à 100 mA mm-1. Un tel succès nous a amené à considérer l’AlN comme un semi-conducteur pratique pour les dispositifs optiques et électriques.
Pour fabriquer ces appareils, nous avons pu faire appel à de nombreux fournisseurs de matériaux. Des échantillons d'AlN de haute qualité sur des substrats saphir de 2 pouces peuvent être achetés auprès de Dowa Electronics Materials, et de l'AlN en vrac de 2 pouces est disponible dans le commerce auprès de Stanley et Asahi Kasei.

Figure 3. (a) Profils de profondeur de la concentration d'impuretés de silicium, d'oxygène et de carbone dans une couche d'AlN implantée dans du silicium de 3 µm d'épaisseur après recuit à 1 600 °C. (b) Profils de profondeur de la concentration en magnésium dans une couche d'AlN implantée en magnésium de 1 µm d'épaisseur après recuit.
Dopage AIN
Le contrôle de la concentration de dopants dans les semi-conducteurs concerne l'incorporation d'impuretés lors de la croissance cristalline, ainsi que la diffusion thermique et éventuellement l'implantation. Cette dernière est une technologie attractive, permettant un contrôle précis du dosage et assurant une grande uniformité latérale du dopant. Cependant, lorsque des implantations à haute dose sont utilisées, elles ont tendance à endommager les réseaux cristallins et à introduire de fortes concentrations de défauts ponctuels, qui peuvent compenser les porteurs. Heureusement, la plupart de ces dommages peuvent être réparés par recuit post-thermique, que nous avons utilisé lors de la production d'un canal AlN de type n implanté dans du silicium.
L’une des caractéristiques impressionnantes des cristaux d’AlN, y compris de leurs surfaces, est leur robustesse à des températures élevées, avec une stabilité sous azote jusqu’à 1 700 °C. Cette robustesse offre une large fenêtre pour réparer les dommages d’implantation – ce processus nécessite des températures supérieures à 1 200 °C pour l’activation électrique de la couche d’AlN implantée en silicium. Notez cependant qu'il faut beaucoup de réflexion lors de la sélection de la température de recuit, car elle peut entraîner d'autres changements dans le matériau. Au-delà de 1 400 °C, les impuretés de silicium et d’oxygène se diffusent au sein de la couche supérieure. En raison de la diffusion des atomes d'oxygène à partir du substrat en saphir, qui se décompose à 1 500 °C sous l'azote gazeux, une fine couche d'AlN sur un substrat en saphir aura une concentration élevée en oxygène après un recuit à haute température, conduisant à des caractéristiques électriques dégradées.
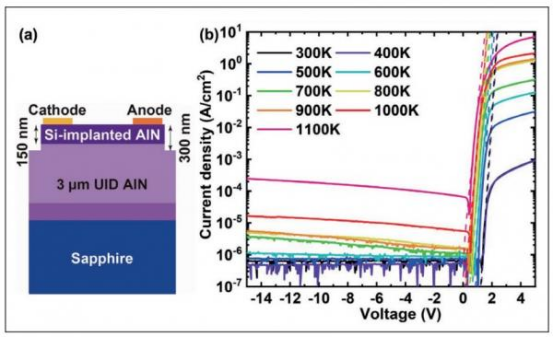
Figure 4. (a) Coupe transversale d'une diode à barrière Schottky avec un canal AlN implanté dans du silicium. Anode Ni/Au et cathode Ti/Al/Ti/Au. (b) Caractéristiques densité de courant-tension d'une diode barrière AlN Schottky de 27 °C à 827 °C.
Grâce à une collaboration avec le MIT, l'Université Aalto, le TNSC et Dowa Electronics Materials, nous avons étudié la diffusion des atomes de silicium, d'oxygène et de magnésium dans l'AlN (voir Figure 3). Nos investigations ont révélé que les atomes d'oxygène diffusant à partir d'un substrat en saphir ne peuvent pas atteindre la couche de canal après le recuit en utilisant des couches d'AlN de 3 µm d'épaisseur. Cela nous a amené à conclure que les plages de températures de recuit préférées pour les couches d'AlN électriquement conductrices avec des implants en silicium et en magnésium sont respectivement de 1 200 à 1 600 °C et de 1 400 à 1 500 °C. Ces connaissances nous ont permis de démontrer les premiers transistors à canal AlN.
Lorsque la fabrication de dispositifs implique des conditions proches de l'équilibre thermique, telles que la croissance épitaxiale et le recuit à haute température, la formation d'états profonds avec des énergies d'ionisation de 250 à 320 meV est favorisée. Cela tend à conduire à une auto-compensation du donneur de silicium, situation en accord avec nos résultats.
Parallèlement, l'utilisation de processus hors équilibre, tels que l'implantation ionique, permet d'augmenter la population de donneurs peu profonds avec des énergies d'ionisation de 64 à 86 meV. Cela a conduit Hayden Breckenridge et ses collègues de l'Université de Caroline du Nord et d'Adroit Materials à produire une couche hautement conductrice d'AlN par implantation de silicium et post-recuit à une température relativement basse de 1 200 °C. Un autre résultat encourageant, venant de l’Université de Kyoto, est que l’énergie de liaison de l’AlN à l’accepteur de magnésium de substitution n’est que de 250 à 410 meV, une valeur bien inférieure à l’énergie d’ionisation des accepteurs de magnésium dans les couches d’AlN courantes cultivées par MOCVD. Pris ensemble, ces résultats indiquent que si les conditions de processus hors équilibre peuvent être contrôlées de manière reproductible et facile dans de l’AlN dopé au silicium et au magnésium, cela pourrait ouvrir la porte à des dispositifs électroniques et optiques aux performances considérablement améliorées.
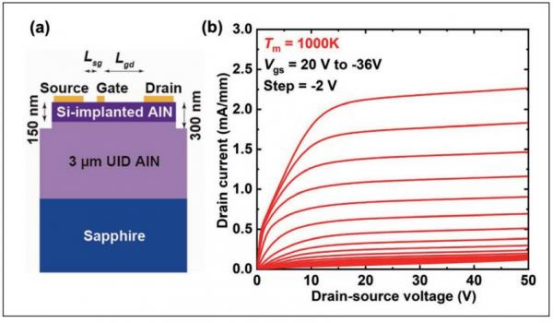
Figure 5. (a) Coupe transversale schématique de MESFET avec un canal AlN implanté dans du silicium. (b) Caractéristiques de sortie CC d'un MESFET AlN à 727 °C.
Propriétés électriques de l’AlN
Pour améliorer les performances électriques des dispositifs à base d'AlN, il ne suffit pas de s'attaquer à la résistivité élevée des couches d'AlN de type N et de type P, altérée par de faibles concentrations de porteurs. De plus, il est nécessaire de s’attaquer à la résistivité de contact élevée, résultant de la faible affinité électronique.
Il est particulièrement difficile d'établir un contact ohmique à température ambiante dans l'AlN. La chute de tension est régie par la hauteur de la barrière Schottky, qui dépend de la différence entre la fonction de travail du métal et l'affinité électronique du semi-conducteur. Il est possible de produire des contacts ohmiques en abaissant la hauteur de la barrière de potentiel grâce à une sélection appropriée des matériaux d'électrode. Les options pour l'AlN de type n sont le titane, l'aluminium, le vanadium et le molybdène, tandis que les contacts ohmiques pour l'AlN de type p peuvent utiliser du palladium et du NiO.
Une implication d'un dopage important dans les matériaux semi-conducteurs est une diminution de la largeur de la région d'appauvrissement, conduisant à un tunnel à travers des barrières potentielles. Le dopage important de la surface supérieure d’AlN est très important pour les contacts ohmiques. Cependant, comme la concentration de dopants silicium et magnésium dans les couches d'AlN est limitée à environ 1019 cm-3, peut-être en raison de la formation de défauts de compensation, il n'y a aucune perspective de tunnel d'émission de champ.
Pour déterminer la concentration et la mobilité des porteurs dans les structures semi-conductrices, les chercheurs ont tendance à se tourner vers les mesures à effet Hall. Comme ces mesures nécessitent un comportement ohmique, certaines études ont utilisé des couches de contact en GaN fortement dopées. Cela a permis de déterminer les propriétés électriques de l’AlN, à la fois à température ambiante et à température élevée. Avec d'autres, nous avons évalué la concentration et la mobilité des porteurs à des températures élevées, obtenant des valeurs pour l'AlN de type n et de type p à des températures supérieures à 200 °C et 500 °C, respectivement.
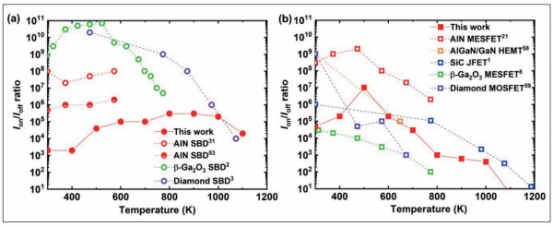
Figure 6. Un tracé d'analyse comparative comparant le rapport marche-arrêt actuel par rapport à la température de mesure des dispositifs AlN avec les autres diodes à barrière Schottky et (b) FET de pointe.
En entreprenant cette étude, nous avons découvert un nouveau problème associé aux mesures à haute température. Nous avons dû utiliser une station de sonde, car nous manquions de technologies de liaison et de boîtier pour les températures extrêmes. Nous avons également constaté que les pointes de sonde normales se détériorent à des températures élevées. Notez que la plupart des appareils signalés ont une température de fonctionnement maximale ne dépassant pas 500 °C, ce qui implique que les mesures des propriétés électriques ne sont pas fiables à des températures supérieures.
En collaboration avec Dowa Electronics Materials, nous avons évalué les caractéristiques électriques de couches d'AlN de 3 µm d'épaisseur sur des substrats en saphir avec un système de sonde haute température offrant une température de mesure maximale de 900 °C sous vide poussé. Pour cet effort, nous avons implanté du silicium dans la couche d'AlN à température ambiante pour obtenir une conductance de type n ; la concentration était de 2 × 1019 cm-3 dans un profil de boîte de 150 nm de profondeur. Ces couches d'AlN implantées dans du silicium ont ensuite été recuites à 1 500 °C. Nous avons ensuite déposé des électrodes Ti/Al/Ti/Au pour contacts ohmiques, avant frittage à 950 °C.
Nos électrodes se sont détériorées à 877 °C, probablement à cause d'une réaction entre Ti/Al et AlN. Cela nous a amené à rechercher des métaux adaptés aux contacts ohmiques à des températures extrêmes. Pour les températures que nous avons pu considérer, nous avons observé une relation courant-tension non linéaire en dessous de 127 °C et quasiment linéaire au-dessus de 227 °C. L'évaluation des propriétés électriques entre 227 °C et 827 °C a révélé que la résistance de la feuille et la résistivité de contact diminuaient avec l'augmentation de la température. De 227 °C à 627 °C, à mesure que la température augmentait, la mobilité électronique diminuait légèrement, mais la concentration électronique augmentait en raison de l’ionisation accrue du donneur, entraînant une réduction de la résistance de la feuille à haute température. Cela nous a amené à conclure que les couches d’AlN de type n présentent d’excellentes performances à des températures extrêmes.
Diodes et transistors
Nous avons fabriqué des diodes barrière Schottky et des MESFET avec des couches d'AlN implantées en silicium sur des substrats en saphir. Nos diodes sont capables de fonctionner à 827 °C (voir Figure 4), dépassant tous les records précédents, tandis que nos transistors peuvent fonctionner jusqu'à 727 °C (voir Figure 5). Les diodes barrière AlN Schottky ont une tension de claquage de 610 V à température ambiante, tandis que la valeur correspondante pour les MESFET AlN à 727 °C est de 176 V. Nous tenons à souligner que ces dispositifs sont réalisables en pratique, car ils ont un simple structure, et les couches d'AlN sont cultivées sur de grands substrats de saphir à faible coût.
Pour fabriquer nos diodes barrière Schottky et nos MESFET, nous avons utilisé du Ni/Au pour les contacts d'anode et de grille. Nous avons constaté que le nickel était thermiquement stable et ne réagissait pratiquement pas avec l'AlN, même à 827 °C. De plus, en termes de caractéristiques électriques, nous avons trouvé peu de différence entre Ni/Au et Pt/Au. Pour la diode barrière Schottky, le courant de coupure est faible, même à 827 °C, en raison de la faible concentration intrinsèque de porteurs et de l'interface Ni/AlN thermiquement stable. Cependant, le courant de drain hors état du MESFET AlN est élevé à 727 °C, en raison des fuites à travers les couches inférieures d'AlN non dopées et de la forte concentration de défauts. Contrairement au courant dans les dispositifs au silicium, qui chute à des températures élevées en raison de la diffusion des phonons, nous avons découvert que le courant direct des diodes à barrière AlN Schottky et des MESFET continue d'augmenter avec une température pouvant atteindre 827 °C. Nous attribuons cela au fait que le courant dans les dispositifs AlN à des températures extrêmes est dominé par l'augmentation de la concentration électronique et la réduction de la résistivité de contact, la réduction de la mobilité électronique jouant un rôle secondaire.
Notre développement de dispositifs AlN ouvre une nouvelle voie pour fabriquer des dispositifs semi-conducteurs pouvant fonctionner à des températures extrêmes. Bien qu'il existe un compromis entre le rapport marche-arrêt et la température des diodes à barrière Schottky et des FET (voir Figure 6), les dispositifs AlN ont un grand potentiel d'amélioration. Par exemple, il devrait être possible d’augmenter le rapport marche/arrêt à des températures extrêmes grâce à une combinaison de croissance homoépitaxiale et d’introduction d’une structure JFET. Des améliorations supplémentaires pourraient provenir de l'introduction de contacts ohmiques tolérants à la chaleur, plutôt que Ti/Al/Ti/Au, une évolution qui augmenterait la température de fonctionnement à plus de 877 °C.
Pour la plupart des applications à températures extrêmes, les circuits intégrés doivent fonctionner de manière fiable sur de longues périodes. De tels circuits sont fabriqués avec une technologie complémentaire, avec des canaux n et p. À l’Université de Kyoto, des ingénieurs ont développé une porte logique JFET complémentaire SiC qui fonctionne à 350 °C. Nous espérons orienter nos travaux dans une direction similaire, en produisant des JFET complémentaires avec des canaux AlN homoépitaxiaux capables de fonctionner dans des environnements extrêmes.
PAR HIRONORI OKUMURA DE L'UNIVERSITÉ DE TSUKUBA
depuis https://compoundsemiconductor.net/article/118570/Extreme-temperature_devices_using_AlN
Pourquoi vous avez besoin de nos services, vous savez que vous obtenez des professionnels hautement qualifiés qui ont l'expertise et l'expérience pour s'assurer que votre projet est fait correctement et fonctionne.
si vous souhaitez une consultation gratuite, veuillez commencer par remplir le formulaire:
Recevez des informations sur les ventes, des nouvelles et des mises à jour dans votre boîte de réception.
 闽ICP备19012761号-1
闽ICP备19012761号-1



